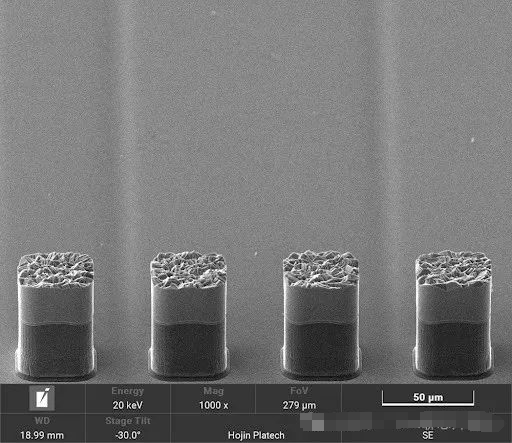
’ は、バンプを作成するプロセスを学習し続けましょう。
1. ウェーハの到着と洗浄:
プロセスを開始する前に、ウェーハ表面に有機汚染物質、粒子、酸化層などが付着している可能性があり、これらを湿式または乾式洗浄方法で洗浄する必要があります。
2. PI-1 リソ: (第 1 層フォトリソグラフィー: ポリイミド コーティング フォトリソグラフィー)
ポリイミド (PI) は、絶縁および支持として機能する絶縁材料です。まずウェハ表面に塗布し、露光、現像してバンプの開口位置を作成します。
3. Ti / Cu スパッタリング (UBM):
UBM は Under Bump Metallization の略で、主に導電性を目的としており、その後の電気めっきの準備をします。 UBM は通常、マグネトロン スパッタリングを使用して作成され、Ti/Cu のシード層が最も一般的です。
4. PR-1 リソ (第 2 層フォトリソグラフィー: フォトレジスト フォトリソグラフィー):
フォトレジストのフォトリソグラフィーによってバンプの形状とサイズが決定され、このステップにより電気めっきされる領域が開きます。
5. Sn-Ag メッキ:
電気めっき技術を使用して、開口部に錫-銀合金 (Sn-Ag) を堆積させてバンプを形成します。カバー画像に示されているように、この時点ではバンプは球形ではなく、リフローも受けていません。
6. PR ストリップ:
電気メッキが完了した後、残っているフォトレジスト (PR) が除去され、以前に覆われていた金属シード層が露出します。
7. UBM エッチング:
バンプ領域を除いて UBM 金属層 (Ti/Cu) を除去し、バンプの下の金属のみを残します。
8. リフロー:
リフローはんだ付けを行うと、錫銀合金層が溶けて再び流れ、滑らかなはんだボール形状が形成されます。
9. チップの配置:
リフローはんだ付けが完了し、バンプが形成された後、チップの搭載を行います。
これでフリップチップ処理は完了です。
次回の新しい内容では、チップの配置に関するプロセスを学びます。

 日本語
日本語 English
English Español
Español Português
Português русский
русский français
français Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba